当前AI快速发展对数据处理提出了更高的要求,先进封装工艺越来越被视为实现芯片更高性能的途径,在超越摩尔时代至关重要,美国加码先进封装,表明其已经成为技术竞争新的战场。
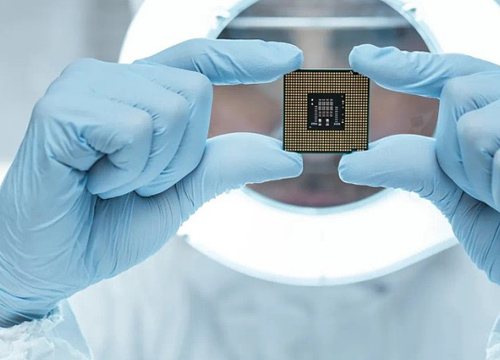
小芯片和混合键合开辟新领域
先进封装已成为半导体创新、增强功能、性能和成本效益的关键。台积电、英特尔和三星等大公司正在采用小芯片和异构集成策略,利用先进封装技术以及前端扩展工作。
Chiplet 方法将 SoC 芯片划分为多个芯片,仅缩放具有先进技术节点的芯片,并使用 2.5D 或 3D 封装将它们集成。这提高了产量并降低了成本。
混合键合 (HB) 是另一个重要趋势,可实现金属-金属和氧化物-氧化物面对面堆叠,且凸点间距小于 10 µm。它用于 CIS 和 3D NAND 堆叠等应用的晶圆到晶圆混合键合,以及用于PC、HPC和数据中心的逻辑上内存堆叠以及3D IC 中的 3D SoC 的持续开发。
与传统封装相比,先进封装需要不同的设备、材料和工艺,例如新的基板材料、光刻工艺、激光钻孔、CMP 和 KGD 测试。先进封装参与者进行了大量投资来开发和引入这些进步。与先进封装的异构集成推动了半导体创新,提高了整体系统性能,同时降低了成本。

头部玩家“血拼”先进封装
在这场先进封装技术竞赛中,台积电占据领先地位。
从技术来看,台积电重心在发展扇出型封装 InFO(Integrated Fan Out,整合扇出型封装)、2.5D 封装 CoWoS( Chip-on-Wafer-on-Substrate , 基板上晶圆上芯片封装) 和 3D封 装 SoIC(System-on-Integrated-Chips,集成芯片系统)。

和台积电相似,英特尔也在先进封装领域布局多年,相继推出 EMIB、Foveros 和 Co-EMIB等先进封装技术,但相关产品的量产时间均落后于台积电。
由于台积电 CoWoS 技术的领先优势,三星近年来错失大陆英伟达和苹果等巨头的芯片代工订单,与台积电的市占率差距不断扩大。为扭转公司封装技术的落后局势,三星持续发力,相继推出 I-Cube、H-Cube 和 X-Cube 三大先进封装技术。

日月光作为目前全球最大的封装测试厂商,于 2022 年推出了 VIPack 先进封装平台,提供垂直互联整合封装解决方案。此平台利用先进的重布线层(RDL)制程、嵌入式整合以及2.5D/3D 封装技术实现超高密度和性能设计的三维异质封装结构。
除了台积电、英特尔、三星和日月光拥有先进封装技术之外,中国大陆的头部厂商在先进封装的开发上也并不落后。例如全球第三、中国大陆第一的封测厂长电科技,已经开发了2.5D/3D封装、晶圆级封装(WLP)、堆叠封装(PoP)等先进封装技术,覆盖面可追平日月光。全球第五、中国大陆第二的通富微电,除了掌握2.5D/3D封装等技术外,还在收购了AMD两大封测厂后与其深度绑定,后者是目前先进封装的最大客户之一。
先进封装的出现,让业界看到了通过封装技术推动芯片高密度集成、性能提升、体积微型化和成本下降的巨大潜力,目前,人工智能(AI)、高性能计算、数据中心、自动驾驶汽车、5G都有先进封装的身影,应用领域逐渐扩大,各大厂商摩拳擦掌地为AI浪潮积极地做准备,一场先进封装技术竞赛已然拉开了帷幕。
说明:本文素材来自于半导体产业纵横及网络公开信息



