什么是IC封装基板?
IC封装基板(IC Package Substrate)是一种用于集成电路(Integrated Circuit,IC)封装的基板,也称为封装载体或封装底板。IC封装基板主要作用是连接芯片引脚和封装外部引脚,同时提供电气连接和机械支撑。IC封装基板通常由绝缘性材料制成,如陶瓷、树脂基板等。
IC封装基板在现代电子产品中扮演着至关重要的角色,它直接影响到集成电路的性能、功耗、散热等方面。
01|封装基板分类
IC封装基板可以根据不同的标准和特点进行分类,以下是一些常见的封装基板分类:
按材料分类:
有机基板:使用树脂作为基板材料,如FR-4基板。
陶瓷基板:使用陶瓷作为基板材料,具有优良的高频特性和散热性能。
金属基板:使用金属材料作为基板,具有良好的散热性能。
按结构分类:
单面基板:只有一层导电层的基板。
双面基板:两层导电层的基板,通常在两面都有焊盘或焊球。
多层基板:由多层绝缘层和导电层组成,用于高密度封装。
按封装形式分类:
BGA(Ball Grid Array):焊球阵列封装,引脚以球形焊点连接到基板上。
QFN(Quad Flat No-leads):无引脚封装,引脚位于封装的四周。
SIP(System in Package):将多个芯片封装在同一基板上形成一个封装单元。
按用途分类:
高频基板:用于高频应用,要求具有较低的传输损耗和良好的高频特性。
高密度互连基板:用于高密度封装,要求引脚布局紧凑、信号完整性好。
散热基板:专门设计用于散热要求较高的封装,具有良好的散热性能。
按制造工艺分类:
刚性基板:采用常规的刚性基板制造工艺。
柔性基板:采用柔性基板制造工艺,适用于需要弯曲或折叠的应用场景。
芯片经过设计、制造之后,需要进行封装测试,IC封装基板用于IC的封装环节,然后再进行PCB的插件、贴片等工序。
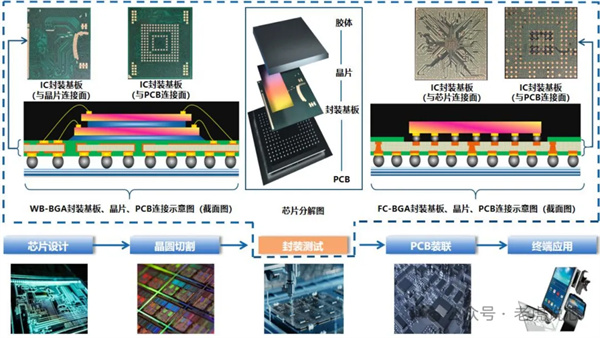
非存储芯片封装基板主要分为逻辑芯片封装基板、通信芯片封装基板和传感器芯片封装基板。逻辑芯片封装基板通常采用FC-BGA/LGA/PBGA工艺,使用BT材料和国产高性能PP材料;通信芯片封装基板一般采用WB-BGA工艺,使用BT材料;传感器芯片封装基板一般采用WB-CSP工艺,也使用BT材料。
存储芯片封装基板主要分为移动存储芯片封装基板、固态存储芯片封装基板、嵌入式存储封装基板和易失性存储芯片封装基板。移动存储芯片封装基板一般采用WB-CSP工艺,使用BT材料;固态存储芯片封装基板、嵌入式存储封装基板和易失性存储芯片封装基板一般采用WB-BGA工艺,同样使用BT材料。
02|IC封装基板产业链
IC封装基板及对应的应用如下:移动存储芯片封装基板(对应于U盘)、固态存储芯片封装基板(对应固态存储器)、嵌入式存储封装基板(对应嵌入式存储器)、易失性存储芯片封装基板(对应动态存储器)、逻辑芯片封装基板(对应逻辑芯片)、通信芯片封装基板(对应SIM卡等)、传感器芯片封装基板(对应指纹传感器等)。

集成电路(IC)封装基板公司的供应链包括原材料和外协加工两个主要环节。原材料采购范围涵盖金盐、覆铜板、铜箔、聚丙烯(PP)、化工材料、干膜、油墨等。外协加工阶段则委托第三方完成,包括钻孔、终检、飞针探测等工艺流程。
该公司的下游客户分为存储器类客户(例如佰维)和封装测试类客户(例如华天)等。存储器类客户主要需求集中在存储器产品的封装基板,而封装测试类客户则需要封装基板用于芯片封装测试。通过与这些不同类型的客户合作,封装基板公司可以满足不同领域的需求,拓展市场份额并提升竞争力。

在芯片封装总成本(不包括晶片成本)中,引线键合(Wire Bonding)封装基板的比例约为40%-50%。而高端的倒装(Flip Chip)封装基板在芯片封装总成本中所占比例更高,大约为70%-80%。
引线键合封装基板和倒装封装基板在成本结构中的比例差异主要源于它们的制造工艺、材料成本以及技术复杂度等方面的不同。选择合适的封装方式可以根据具体的应用需求和成本考量来进行权衡,以确保在满足性能需求的同时,实现成本效益的最大化。
行业内IC封装基板的具体分类、示例及应用如下:
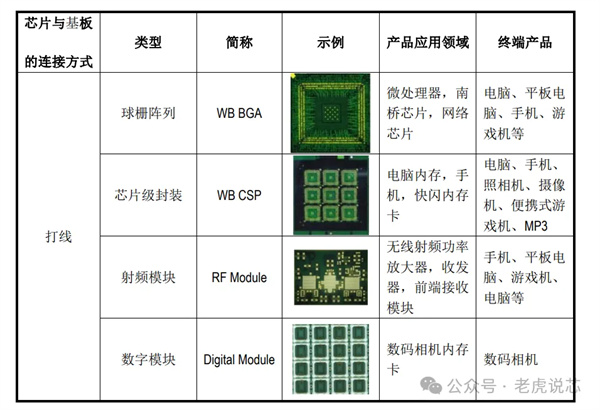
IC封装基板根据应用领域可分为两类:一类是应用于模拟芯片的封装基板,模拟芯片主要用于模拟集成电路(analog IC)。典型的模拟芯片包括无线射频模块芯片。针对这类芯片的封装基板称为无线射频模块封装基板。
另一类是应用于数字芯片的封装基板,数字芯片包括基带芯片、应用处理器芯片、内存卡芯片等。这些数字芯片通常需要高度集成和高性能的封装基板。常见的数字芯片封装基板包括WBBGA(Wire Bond Ball Grid Array)、WBCSP(Wire Bond Chip Scale Package)、FCBGA(Flip Chip Ball Grid Array)、FCCSP(Flip Chip Chip Scale Package)等。

03|IC封装基板工艺分类
IC封装基板的生产采用两种主要工艺制程方式:Tenting(减成法)制程和 mSAP(改良型半加成法)制程。
Tenting制程的关键在于利用蚀刻等方法去除覆铜板表面多余的铜,从而形成所需的导电线路。然而,由于蚀刻工艺的限制,线路在蚀刻过程中需要保留一定量的底铜,以避免线路被蚀断。因此,Tenting制程通常难以制作线宽/线距小于30/30μm的线路。
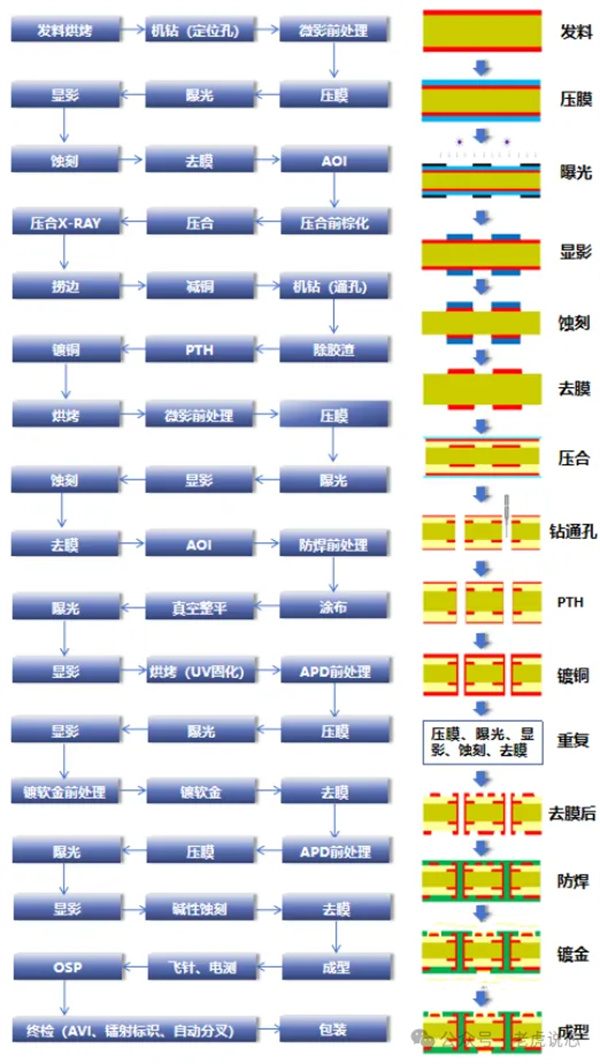
mSAP制程的关键在于利用干膜覆盖不需要的线路,然后在覆铜板的超薄铜箔上进行铜的加厚,形成所需的导电线路。随后通过闪蚀工艺快速去除不需要的线路,最终得到完整的导电线路。mSAP制程具有制作线宽/线距小至25/25μm及以下的产品的能力。
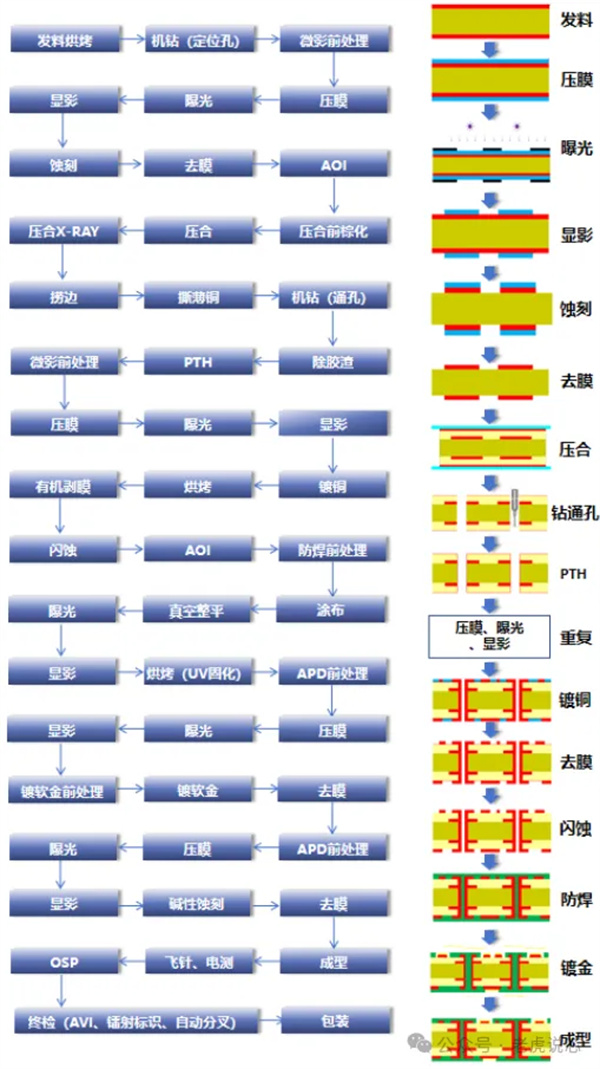
IC封装基板主要工序如下:
发料烘烤:通过去除板材表面的潮气水分,稳定基板尺寸,减少热应力,保证后续工艺的稳定性。
压膜:将感光干膜覆盖在基板铜面上,为后续曝光和显影做准备。
曝光:利用激光扫描技术直接在基板上成像,形成电路图案。
显影:通过显影液处理,固化保留曝光部分的干膜,去除未曝光部分的干膜。
镀铜:在铜箔表面通过化学方法镀上一层一定厚度的铜,增加导电性。
去膜:利用退膜液去除板面覆盖的干膜,露出需要回蚀部分的铜箔。
蚀刻:通过快速蚀刻或普通蚀刻工艺,形成所需的电路图形。
AOI:利用自动光学检测技术检查蚀刻完成的线路,确保质量。
压合:将铜箔、PP和覆铜板叠合,高温高压下粘结为一体,形成多层板。
钻孔:利用钻机对覆铜板进行钻孔,为后续PTH工艺做准备。
PTH:镀通孔,形成导电铜层以实现双面铜箔的连接。
防焊:覆盖防焊漆材料,保护线路不受氧化或污染。
镀金:在金手指或镍面上镀上一层金层,提高导电性和耐腐蚀性。
成型:通过铣刀将基板铣成标准外形尺寸。
OSP:通过除油剂除油,对铜焊盘进行抗氧化处理。
终检:对成品进行全面检测,确保产品符合规格要求。
这些工序共同构成了IC封装基板的制造过程,每个步骤都至关重要,影响着最终产品的质量和性能。
艾斯达克始终秉持以客户需求为核心,通过智能装备、精密科技驱动,工业软件打通数据流,数据+AI算法赋能电子及半导体行业智慧仓储,专注产品品质,用心服务的初心。艾斯达克帮助企业解决智能仓储领域的科学化、标准化、数字化、自动化、智能化升级时遇到的实际问题,提供智慧仓储设备定制化服务。未来艾斯达克将继续发挥技术人才和资源方面的优势,为制造业的转型升级贡献力量。在这个过程中,艾斯达克将助力更多HBM生产制造型企业,携手共进,共同推动我国制造业迈向全球价值链顶端。
部分图文引用自《老虎说芯》公众号